Структура металл диэлектрик полупроводник
Обновлено: 05.07.2024
структура состоящая из последовательноrо сочетания металла, диэлектрика и полупроводника.
- Telegram
- Вконтакте
- Одноклассники
Еще термины по предмету «Электроника, электротехника, радиотехника»
Плотность энергии электромагнитного поля (Electromagnetic energy density)
физическая величина, равная отношению энергии электромагнитного поля в некотором объеме к этому объему.
Потери энергии при включении (Turn-on loss energy)
энергия, рассеиваемая полупроводнuковым прибором при включении.
Преобразователь с передачей накапливаемой энергии (Flyback converter)
преобразователь постоянного тока, в котором энергия источника сначала накапливается в электрическом реакторе, а затем передается в нагрузку на интервале выключенного состояния главного плеча (плеч) .
Похожие
- Структура металл-диэлектрик-полупроводник
- Металл-диэлектрик-полупроводник-структура (МДП-структура )
- Структура металл-окисел-полупроводник
- Полевой транзистор типа металл-диэлектрик-полупроводник
- Диэлектрик
- Диэлектрики
- Полупроводники
- Полупроводник
- Металл
- Полевой транзистор типа металл-окисел-полупроводник
- Металл, простой металл
- Черные металлы, железные металлы
- Активный диэлектрик
- Влагопоглощение диэлектрика
- Влагостойкость диэлектрика
- Водопоглощение диэлектрика
- Водостойкость диэлектрика
- Дугостойкость диэлектрика
- Кондиционирование диэлектрика
- Короностойкость диэлектрика
Научные статьи на тему «Структура металл - диэлектрик - полупроводник»
1. Особенности зонной структуры диэлектриков, полупроводников и металлов
В отношении зонной теории различие электрических свойств проводников, диэлектриков и полупроводников.
Зонная структура диэлектриков Валентная зона, которая объединяет внешние электроны атомов или ионов.
Зонная структура полупроводников В том случае, если полностью занятая электронами зона разделена с ближайшей.
На рис. 3 изображено расположение энергетических зон полупроводника и диэлектрика.
Зонная структура металлов Определим условия проводимости металлов.
2. Электронные процессы в полупроводниковых диодах и структурах металл диэлектрик полупроводник
Представлены результаты теоретического и экспериментального исследования переходных процессов в полупроводниковых диодах с тонкой базой. Излагаются основные результаты, полученные при изучении физической природы эффектов переключения и памяти в тонкоплёночных диодных структурах на основе халькогенидных и оксидных стеклообразных полупроводников. Рассматривается влияние центров с глубокими уровнями на вольт-амперные характеристики диодов из GaAs. Подводится итог исследованиям, направленным на р.
3. Электроматериаловедение
Структура.
Согласно данному признаку электроматериалы делятся на диэлектрики, проводники и полупроводники.
Полупроводники представляют собой материалы с узкой запрещенной зоной, которая преодолевается благодаря.
Согласно данному признаку диэлектрики делятся на органические и неорганические. Структура.
Согласно данному признаку диэлектрики делятся на материалы с молекулярной структурой, с ионной структурой
4. Оптические, ИК- и ТГц-экраны на основе слоистых структур металл–диэлектрик–полупроводник
Рассмотрены многослойные покрытия из наноразмерных слоёв металл–диэлектрик–полупроводник, расположенных на прозрачной подложке, описываемые на основе модели Друде–Лоренца и представляющие собой многополосные фильтры – экраны для различных диапазонов. Исследуются структуры с несколькими слоями и квазипериодические структуры. Предложен метод приближённого синтеза по полосам заграждения для структур типа два слоя в периоде и три слоя в периоде. Для трёх слоёв различие в плазменных частотах позво.
1.4. Структура "металл-диэлектрик-полупроводник"
1.4.1. Расчет дифференциальной емкости МДП-структуры. Структура МДП является основой ряда дискретных приборов твердотельной электроники, а также элементов интегральных схем. К их числу относятся полевые транзисторы (МДП-транзисторы), приборы с зарядовой связью (ПЗС-структуры), варикапы и др. В основе их функционирования лежит принцип эффекта поля.
Эффектом поля называют явление изменения продольной проводимости полупроводника под действием поперечного электрического поля. Суть этого явления заключается в воздействии на поверхность полупроводника внешним полем и управлении величиной поверхностного изгиба зон. Данный эффект используется также в некоторых методах диагностики поверхностных состояний в полупроводниках.
МДП-транзисторы являются униполярными активными элементами интегральных схем. Наряду с этим, МДП-структуры можно использовать в качестве конденсаторов и резисторов, номинальные значения которых изменяются в определенных пределах при изменении приложенного потенциала к управляющему электроду. Кроме того, МДП-структуры могут также выполнять функции элемента памяти. Особенно широко МДП-транзисторы применяются при построении цифровых интегральных схем.
Существует две разновидности МДП-транзисторов: с индуцированным и проводящим каналами.
Анализ показывает, что вольт-амперная стоковая характеристика МДП-транзистора с индуцированным каналом описывается формулой
где Z и L – соответственно ширина и длина канала; μ – подвижность носителей заряда в канале; CD – удельная емкость МДП-структуры, определяемая соотношением , в котором εD – диэлектрическая проницаемость подзатворного диэлектрика, d – его толщина; Uc – напряжение между истоком и стоком; Uз – напряжение на затворе; Uз отп – напряжение отпирания, при котором формируется (индуцируется) проводящий канал между истоком и стоком.
Из выражения (1.49) видно, что напряжение отпирания, называемое также пороговым напряжением Uпор МДП-транзистора, является его важным параметром.
При этом напряжении в приповерхностной области полупроводника формируется пространственный заряд, соответствующий режиму сильной инверсии.
Упрощенное выражение для порогового напряжения для «n» – канального МДП-транзистора имеет вид
Соответствующее выражение для «p» – канального МДП-транзистора
В (1.50) и (1.51) Uпз – напряжение плоских зон; φоб – объемный потенциал; Qs – полная поверхностная плотность заряда в полупроводнике.
Для МДП-структуры в предположении, что разность работ выхода электрона из металла и полупроводника не равна нулю, а в диэлектрике МДП-структуры и на границе раздела диэлектрик-полупроводник отсутствует заряд поверхностных состояний, напряжение плоских зон будет определяться разностью потенциалов φMS соответствующей разности работ выхода Uпз = φMS.
Величину φMS можно определить из соотношения
для полупроводника n-типа и
для полупроводника p-типа.
Второе слагаемое в выражениях (1.50) и (1.51) определяет величину поверхностного потенциала φS, при котором начинается сильная инверсия
Третье слагаемое в (1.50) и (1.51) определяет величину падения напряжения на слое диэлектрика, которое, используя закон Гаусса, можно определить как
где ED – напряженность электрического поля на диэлектрике.
Таким образом, для идеальной МДП-структуры величина порогового напряжения определяется выражением
где N = NА или ND, в зависимости от типа проводимости полупроводниковой подложки МДП-транзистора. Знаки (+) и (–) определяются типом проводимости индуцированного канала между истоком и стоком. Величина объемного потенциала определяется соотношением .
Максимальная толщина обедненного слоя в приповерхностной области полупроводника формируется в режиме сильной инверсии и находится из выражения
При изготовлении интегральных микросхем, а также силовых полупроводниковых приборов в качестве затворного электрода широко применяются слои сильнолегированного поликремния. Для поликремниевых затворов n + -типа, где уровень Ферми практически совпадает с положением дна зоны проводимости, эффективная работа выхода φm равна величине сродства к электрону в кремнии (æSi = 4,15 В). В поликремниевых затворах p + -типа, где уровень Ферми совпадает с потолком валентной зоны, эффективная работа выхода .
В прил. 7 приведена зависимость разности работ выхода φms от уровня легирования кремниевой подложки для МДП-структур с затворными электродами из Al, Au и поликремния n + и p + -типа.
Из этих графиков следует, что в зависимости от материала затвора при нулевом напряжении смещения приповерхностная область полупроводника МДП-структуры может оказаться практически в любом состоянии (от обогащения до инверсии).
Полная удельная емкость МДП-структуры определяется соотношением
которое соответствует последовательному соединению емкости ОПЗ полупроводника и емкости диэлектрика
Величина емкости CD определяется толщиной диэлектрика и представляет собой максимально возможную емкость всей структуры CD = Cmax.
Емкость ОПЗ полупроводника не является постоянной и ее величина определяется изменением поверхностной плотности заряда QS при изменении приложенного к МДП-структуре напряжения:
В отсутствие разности работ выхода приложенное напряжение делится между полупроводником и диэлектриком:
Таким образом, можно определить зависимость полной емкости МДП-структуры от приложенного напряжения.
Особый интерес представляет величина полной емкости МДП-структуры в режиме сильной инверсии Cmin, т.е. при U = Uпор, так как она определяет значение коэффициента перекрытия по емкости поверхностного варикапа.
Соответствующее Uпор значение удельной дифференциальной емкости идеальной МДП-структуры равно
1.4.2. Порядок построения энергетической диаграм-мы МДП-структуры. Для построения энергетической диаграммы МДП-структуры в режиме сильной инверсии необходимо определить следующие электрофизические характеристики:
концентрацию примесей в полупроводнике;
величину объемного потенциала (φобn, φобp), позволяющего определить положение уровня Ферми в полупроводнике, используя формулы (1.5 а), (1.5 б) и, считая, что концентрация основных носителей заряда равна концентрации донорной или (в зависимости от типа проводимости полупроводника) акцепторной примеси (атомы примеси полностью ионизированы), т.е. и ;
величину изгиба энергетических зон в приповерхностной области полупроводника, в которой локализован пространственный заряд, соответствующего режиму сильной инверсии ;
величину ширины области пространственного заряда в приповерхностной области полупроводника Wm в режиме сильной инверсии;
значение толщины диэлектрического слоя;
величину порогового напряжения.
По полученным и исходным данным строится энергетическая диаграмма.
1. Выбирается масштаб: по вертикали в эВ, по горизонтали в мкм или в нм (см. п. 1.2.8. Порядок построения энергетической диаграммы p–n-перехода).
2. Проводятся вертикальные пунктирные линии, обозначающие границы "затвор-диэлектрик" и "диэлектрик-полупроводник". Проводится (произвольно) горизонтальная линия – линия уровня Ферми в полупроводнике, обозначается Efn (или Efp).
3. Проводится вертикальная пунктирная линия, обозначающая границу области пространственного заряда в приповерхностной области полупроводника, расстояние от нее до границы с диэлектриком равно рассчитанному значению Wm.
4. На расстоянии, равном величине рассчитанного объемного потенциала, выше (в случае, если полупроводник р-типа) или ниже (в случае, если полупроводник n-типа) от уровня Ферми проводится горизонтальная линия, соответствующая уровню середины запрещенной зоны полупроводника, обозначается Ei.
5. Параллельно линии Ei на расстояниях, равных половине величины запрещенной зоны полупроводника Eg/2, проводятся горизонтальные линии:
- выше Ei – линия уровня дна зоны проводимости, обозначаемая Ec,
- ниже Ei – линия уровня потолка валентной зоны, обозначаемая Ev.
6. В пределах 0 Wm линии, соответствующие Ec, Ev и Ei, представляются изогнутыми относительно нейтральной области полупроводника по параболическому закону. Величина (по вертикали) изгиба энергетических уровней на поверхности полупроводника в точке x = 0 (граница раздела "диэлектрик-полупроводник") равна удвоенному значению объемного потенциала, т.е. qs = 2qоб.
7. В ОПЗ через точку пересечения линий уровня Ферми и середины запрещенной зоны полупроводника проводится вертикальная пунктирная линия, обозначающая границу слоя инверсной проводимости.
8. Отрезками горизонтальных линий отображается область диэлектрика, указывается толщина диэлектрика d.
9. Проводится горизонтальная линия, соответствующая уровню Ферми в затворе, таким образом, чтобы она располагалась выше (или ниже) линии уровня Ферми в полупроводнике (подложке) на величину порогового напряжения (qUпор ), обозначается EfМ.
План лекции
Структура металл - диэлектрик - полупроводник (МДП) является основой целого ряда полупроводниковых приборов и, в частности, элементов интегральных микросхем. Предполагается, что слушатель знаком с основами физики полупроводниковых приборов, например, в объеме учебного пособия [1], в частности знаком с основными положениями теории МДП структуры и МДП транзистора. Поэтому в настоящем параграфе будут приведены лишь основные сведения о МДП структуре, принятые обозначения и определения.
В качестве диэлектрика в кремниевых ИМС чаще всего используется SiO2 (структура МОП). Зонные диаграммы структуры металл-окисел-полупроводник изображены на рис. 2.1.
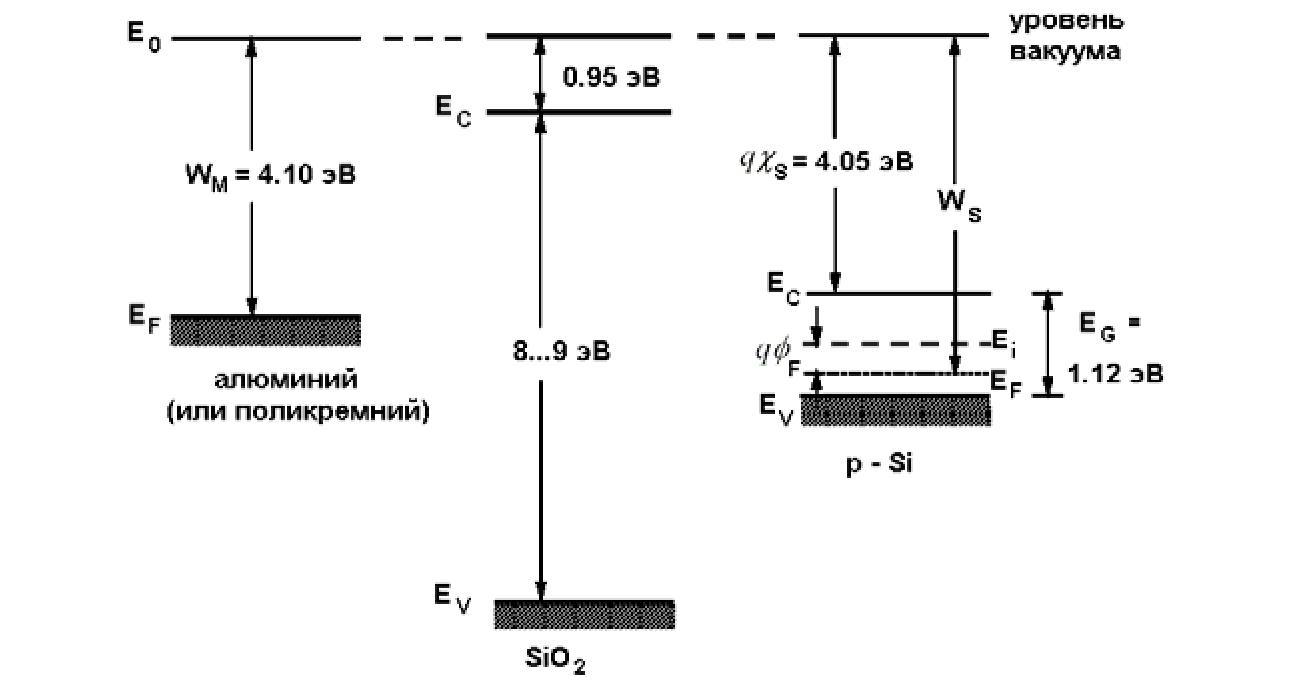
Рис. 2.1. Зонные диаграммы алюминия, SiO2 и кремния р-типа с концентрацией легирующей примеси NA
Здесь Е0 - уровень энергии электрона в вакууме (точнее уровень свободного электрона), ЕF − уровни Ферми в металле и полупроводнике, (4,05 эВ) − сродство к электрону (electron affinity) кремния (Si), (0,95 эВ) − сродство к электрону SiO2, .
В невырожденной кремниевой p-подложке с объемной плотностью акцепторов NA равновесные концентрации дырок и электронов выражаются формулами

, (2.1.1)

где − потенциал Ферми в объеме, характеризующий положение уровня Ферми относительно середины запрещенной зоны кремния.
Прикладывая положительное напряжение к затвору, мы увеличиваем потенциал в объеме p-кремния и на границе раздела. При этом концентрация электронов экспоненциальным образом увеличивается, а дырок − уменьшается. В частности, для объемной концентрации электронов и дырок на границе раздела с окислом имеем

(2.1.2)

где − поверхностный потенциал.
При этом возможны четыре основные ситуации, которые поясняются рисунками 2.2а,б,в,г.

1) Приложенное напряжение отрицательно (, рис. 2.2а). Поле в полупроводнике экранируется избыточными дырками, концентрация которых вблизи поверхности полупроводника повышается. Такой режим называетсярежимом обогащения. Положительный заряд избыточных дырок в полупроводнике уравновешен отрицательным зарядом электронов на поверхности затвора. Электрическое поле проникает в полупроводник на глубину порядка дебаевской длины экранирования в подложке.
2). Приложенное напряжение положительно и не превышает некоторой величины , называемой напряжением инверсии (рис. 2.2б) −. В этом режиме энергетические зоны искривляются в противоположную сторону. Величина поверхностного потенциала положительна и не превышает величины:

(2.1.3)
Очевидно, что приповерхностный слой полупроводника обеднен основными носителями (режим обеднения). При условии (2.1.3) уровень электростатической энергии остается выше уровня Ферми, поэтому концентрация неосновных носителей (электронов) весьма мала ().

Ширина xd и плотность заряда обедненной области на единицу площади для однородно-легированной подложки определяются условием электронейтральности и выражаются в приближении обедненного слоя простыми зависимостями от поверхностного потенциала

,(2.1.4)


.(2.1.5)
Соотношение (2.1.4) аналогично соотношению, определяющему ширину резко несимметричного p-n перехода с заменой контактной разности потенциалов на поверхностный потенциал.
Отсюда легко получить удельную (на единицу площади) емкость обедненной области

.(2.1.6)
При увеличении напряжения до некоторой величинывыполняется условие. В этом случае уровень Ферми на границе диэлектрик-полупроводник (x = 0) совпадает с уровнем электростатической энергии Ei, что соответствует равенствам . Напряжениеназываетсянапряжением инверсии.
3). Приложенное напряжение превышает напряжение инверсии (, рис. 2.2в). В этом режиме, и в приповерхностном слое полупроводника уровень электростатической энергии расположен ниже уровня Ферми. В соответствии с (2.1.1) в этой области концентрация неосновных носителей больше, чем основных (), т.е. инвертируется тип проводимости подложки. Этот режим называетсярежимом инверсии. При условии получим:

.
Такой режим называется режимом слабой инверсии. В режиме слабой инверсии практически во всей ОПЗ () концентрации подвижных носителей заряда остаются много меньшими, чем в подложке, поэтому толщина ОПЗ определяется соотношением (2.1.4). Концентрация электронов максимальна на поверхности () и резко убывает при.
4) При имеет местосильная инверсия () (рис. 2.2г). Условиевыполняется при некотором значении приложенного напряжения, которое называетсяпороговым напряжением МДП-структуры. При увеличении напряжения до значения ширина ОПЗxd возрастает в соответствии с (2.1.4) вследствие увеличения поверхностного потенциала до , достигая значения xdmax

. (2.1.7)

Дальнейшее увеличение напряжения (переход в область сильной инверсии) не приводит к заметному расширению ОПЗ, так как тонкий инверсионный слой экранирует ОПЗ от электростатического воздействия со стороны затвора. При повышении напряжения электрическое поле увеличивается только в диэлектрике. Толщина инверсионного слоя в режиме сильной инверсии имеет порядок дебаевой длины экранирования (~5-10нм).
Особенности зонной структуры диэлектриков, полупроводников и металлов
Зонная теория - это квантовая механическая теория, которая рассматривает движение электронов в твердом теле.
Зонная теория твердого тела
Согласно теории, свободные электроны могут обладать любой энергией. Электроны в атомах твердого тела могут иметь только определенные дискретные значения энергии. Другими словами, спектр энергии электронов в атомах состоит из разрешенных и запрещенных энергетических зон.
Положения зонной теории
Итак, согласно постулатам Бора, электрон в отдельном атоме может находится на одной из нескольких энергетических орбиталей. Иначе говоря, иметь лишь определенные дискретные значения энергии. Когда атомы образуют молекулу, количество орбиталей расщепляется пропорционально числу атомов в молекуле.
При увеличении количества молекул до макроскопического тела количество орбиталей становится очень большим, а разница между соответствующими им энергиям - очень маленькой. Орбитали сливаются, образуя энергетические зоны.
Валентная зона - в диэлектриках и полупроводниках наивысшая энергетическая зона, которая заполнена полностью при температуре 0 К. Зона проводимости - следующая за валентной зона. В металлах зоной проводимости называется наивысшая разрешённая зона, в которой находятся электроны при температуре 0 К.
Зонная теория объясняет различие в электрических свойствах материалов: проводников, полупроводников, диэлектриков. Можно выделить следующие причины различий:
- Ширина запрещенных энергетических зон
- Разница в заполнении разрешенных энергетических зон электронами.
Зонная структура диэлектриков
Вещество является диэлектриком, когда валентная зона заполнена полностью, в высших зонах нет электронов, также отсутствует перекрытие зон. Такое вещество не проводит ток. Ширина между зонами у диэлектриков условно составляет более 2 электронвольт.
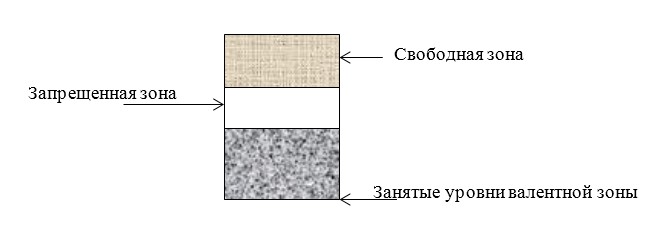
Зонная структура полупроводников
Вещество является полупроводником, если валентная зона разделена с соседними зонами узкой (менее 2 электронвольт) запрещающей зоной. Отметим, что такое вещество при температуре, близкой к абсолютному нулю, является диэлектриков. Однако при росте температуры электроны из верхней занятой зоны перескакивают в вакантную зону проводимости, и вещество становится электропроводным. Проводимость растет вместе с температурой и концентрацией электронов в зоне проводимости. Соответственно, в заполненной зоне, из которой электроны переходят в зону проводимости, растет концентрация дырок.
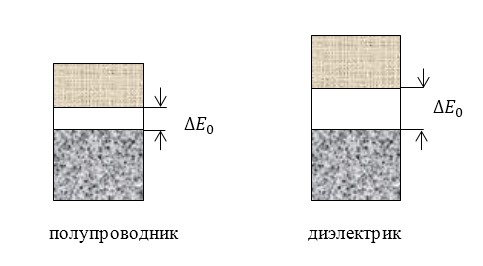
Разделение веществ на полупроводники и диэлектрики весьма условно. Вещества с шириной запрещённой зоны более 3—4 эВ и менее 4—5 эВ совмещают свойства диэлектриков и полупроводников.
Зонная структура проводников (металлов)
В металлах валентная зона занята не полностью, и при воздействия на проводник разности потенциалов электроны могут свободно перемещаться из точек с меньшим потенциалом в точку с большим потенциалом.
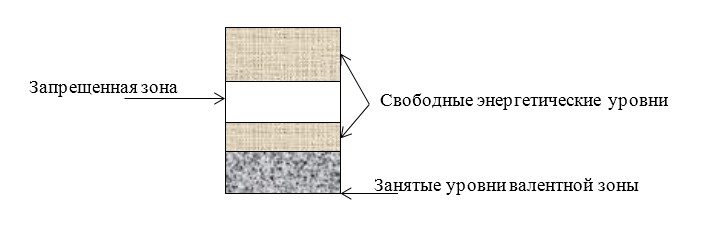
Также в проводниках зона проводимости пересекается с валентной зоной. Получившаяся зона пересечения заполнена не полностью.
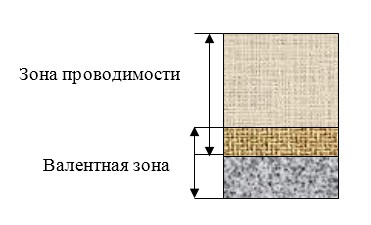
Почему проводимость металлов не растет с увеличением валентности?
Валентность - это способность атома вещества образовать определенное число химических связей. Проще говоря, способность "прикрепить" к себе другой атом.
Однако электропроводность зависит не от количества валентных электронов на один атом, а от числа электронов в валентной зоне, для которых существуют свободные энергетические уровни. Так, у двухвалентных металлов число электронов, которые могут перейти под действием внешнего поля в свободное состояние меньше, чем у одновалентных. Таким образом, электропроводность двухвалентных металлов меньше, чем одновалентных.
Читайте также:
